- Intel представила новые технологии упаковки чипов для мощных ИИ-систем.
- Комбинация трёх технологий позволяет разместить 10 000 мм² кремния в одном корпусе.
- Закон Мура замедляется, производителям GPU и других чипов приходится увеличивать площадь кремния.
- Максимальный размер одного кристалла ограничен примерно 800 мм², поэтому компании переходят на продвинутые методы упаковки.
- Intel представила три ключевые инновации: улучшенную технологию соединения кристаллов, более точный метод крепления кристаллов к подложке и усовершенствованную систему отвода тепла.
- EMIB (Embedded Multi-Die Interconnect Bridge) - тонкая кремниевая пластина, встроенная в органическую подложку, содержит микроскопические соединения для повышения плотности контактов.
- Новая версия EMIB-T добавляет вертикальные медные соединения (TSV) для уменьшения потерь энергии и снижения помех.
- Термокомпрессионное соединение улучшает крепление кристаллов к подложке, делая процесс расширения более предсказуемым и увеличивая плотность соединений.
- Улучшенный теплоотвод обеспечивает ровную поверхность и надежность теплораспределителя при высоких температурах.
Intel модернизирует корпус чипа для ИИ. 10 000 квадратных миллиметров кремния в одном корпусе
25 июл 2025
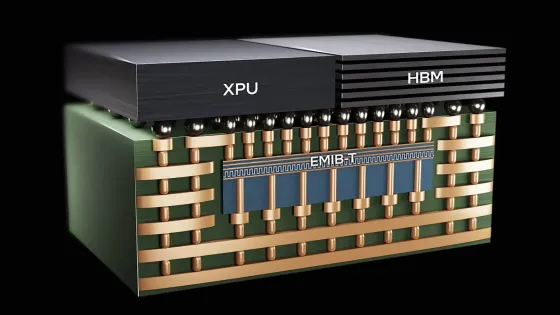
Краткий пересказ
от нейросети YandexGPT
Источник:
habr.com
Обложка: Изображение из статьи